

2017/07/27 恩智浦首创IoT专用单芯片SCM-i.MX6 FO PoP SiP
•第一款专为IoT应用设计,具有启动存储器boot memory和PMIC电源管理组件的超小型多芯片低功耗集成堆栈封装兼容组件。•NXP恩智浦的模块是新兴的先进封装技术如FO PoP SiP的最佳演示。
先进封装是一个关键的新兴技术,不仅可以支持封装,而且还能为最终产品提供更多的价值,并降低所需成本。从市场营收来看,2016年至2022年间的7%复合年增长率显示先进封装产业无疑是个很有活力的市场,而创新在此将扮演关键角色。恩智浦NXP的单芯片扇出型/堆叠/系统级封装系统SCM-i.MX6Q FO PoP SiP配备启动存储器和电源管理员建,是先进封装平台演进的一个绝佳例证。因此,恩智浦提出了SiP和PoP集成的简单但精巧结合,具有非常小的外形尺寸,适用于各种IoT物联网应用。
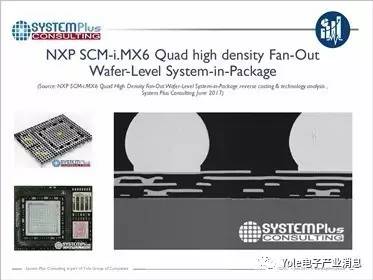
Yole Développement(Yole)的姊妹公司System Plus Consulting的技术和市场分析师Jérôme Azémar表示:“NXP的模块是新兴先进封装技术,如FO PoP SiP等的体现。透过这种设计,NXP让自己与其他公司有所区隔,与长年来的合作伙伴Nepes合作,明确表明其战略重点是集成多个芯片,以创建具有更高附加值的模块。”

NXP的模块最初是为简单的IoT应用而开发,然而,这种SiP封装技术未来也有机会向高阶市场发展,未来的动态值得观察期待。
System Plus Consulting就NXP FO PoP SiP推出逆向工程和成本分析报告NXP SCM-i.MX6 Quad HighDensity Fan-Out Wafer-Level System-in-Package report.。该报告分析完整的PoP SiP解决方案,包括die晶粒分析、流程和封装横截面等内容,同时提供与竞争解决方案的比较,如台积电的inFO整合扇出晶圆型封装和新光电气的MCeP 内埋式组件及PoP堆栈封装技术等,最后,此报告也包含系统的完整成本分析和售价估算。
在不少应用中,将多个组件集成在一个超小尺寸封装体上的系统级封装技术已成为一大挑战。像IoT物联网这样的新兴市场带来了新的系统配置需求,市场开始寻求更低功耗且高性能的产品。恩智浦因此引入了一个尺寸迷你的晶圆级系统封装SiP,一款已在汽车应用中得到认可的应用处理器,结合电源管理PMIC和基于闪存技术的boot memory,其所需覆盖区仅需原有标准PCB分立组件封装方式的一半。
专为IoT应用量身打造,NXP的模块包括i.MX6-Quad应用处理器,MMPF0100电源管理系统,16MB闪存和大约100个表面贴装组件,均配置在小于200 立方毫米的单一封装体中。
System Plus Consulting的先进封装和射频成本工程师Stéphane Elisabeth表示:“这是我们在市场上所见的第一款将多芯片经扇出型封装加工的产品,是扇出SiP技术的一个关键里程碑。”
该系统使用Nepes开发的非传统常规晶圆级封装,以创新的方式互相连结,将美光Micron的SDRAM存储器芯片以PoP堆栈封装。一项被称为Via Frame的客制化芯片重新分配技术,允许存储器堆栈。这些组件集成在几个重新配层设计RDL的环氧模型树脂封装体EMC中。
来自System Plus Consulting的Stéphane Elisabeth表示:“基于NXP i.MX6 Quad应用处理器的技术构建,且采取PoP封装,SCM-i.MX6Q具有非常高的功率效率。”这使得它很适合通过简化高速存储器设计,并显著降低处理器/ PMIC /存储器子系统的整体设计复杂度来缩短产品上市时间。受惠于应用于SiP的重新分配芯片封装技术,恩智浦已经实现了一个完整、超小尺寸、低功耗、且高性能的解决方案。
下一步是什么?根据Yole分析师的说法,FO仍然是发展最快的先进封装平台,从市场营收来看,2016年至2022年之间的年均复合增长率达36%。 System PlusConsulting和Yole相信,FO SiP将在不久的将来深入市场。而在即将推出的新苹果手机iPhone8中使用自家最新处理器A11,就会是一个很好的例子。有鉴于此,两家合作伙伴将以此为方向进行调查,分析新兴技术,并与市场发展和先进封装公司领先的战略对应连结。
购买或近一步了解报告内容请洽 miathintoninfo.com at请换成@
System Plus Consulting和Yole在各大主要贸易展览和会议上,展示了他们对产业、技术演进和市场趋势的看法,近期活动如下:
- SEMICON Taiwan 台湾半导体展(09/12-09/15)Yole分析师将于摊位#828与您见面- IWLPC(10/25, 2:15PM )System PlusConsulting的CTO Romain Fraux将为您主讲“TechnologyTrends for Sensors using WLP and 3D TSV Integration”。
相关报告(1) Statusof the Advanced Packaging Industry report, Yole Développement, May 2017 (2) Fan-Out:Technologies & Market Trends 2016 report, Yole Développement, 2016
专有名词一览
FO PoP SiP : Fan-OutPackage-on-Package System-in-Package 扇出型堆栈系统级封装
PMIC : PowerManagement Integrated Circuit电源管理IC
PCB : Printed CircuitBoard印刷电路板
PoP :Package-on-Package堆栈式封装
EMC : Epoxy MoldingCompounds环氧树脂模塑料
RDL : RedistributionLayer重分布层







